从原理到应用,深刻解读九博体育官方app全新一代老化测试机台
引言
近年来,半导体芯片在国内和国际上的影响力越来越大。众所周知,半导体是电子产品的基石,被誉为“工业粮食”。目前,中国是世界上最大的芯片市场,每年需要大批量进口芯片。2020年中国进口芯片超2.4万亿,相比之下,2020年石油原油进口总额约为1.22万亿,意味着国内芯片进口规模超过了石油一倍,依然是国内进口规模最大的行业之一。
随着信息技术的迅猛发展,半导体集成电路成为战略武器系统、航空航天电子设备、工业控制、汽车电子等科技领域的核心部件,集成电路的可靠性成为制约各行各业硬件设施可靠性的关键因素,其重要性甚至不亚于集成电路的电气性能指标本身。
由于集成电路生产过程结构精细、工艺复杂、流程繁琐,不可避免地会在生产过程中留下潜在缺陷,使器件的可靠性水平不能达到设计要求,存在诸多可靠性问题。如何尽早使集成电路的故障暴露出来,在使用前将其筛出,是提高芯片使用可靠性的重要手段。老化试验就是将产品早期故障剔除的无损试验手段。
老化原理及作用
半导体器件的可靠性和典型寿命通常可以用浴盆曲线来描述(图1)。这是一个产品寿命随时间的变化图形,如图所示由三个关键时期组成。第一个时期是早期失效期,特点是产品失效率起始值很高,随后急速下降。这一时期的失效主要是由产品设计、材料、工艺或制造过程中的缺陷和失误引起的。第二个时期正常使用期内的失效是随机失效,失效率低且相对恒定。第三个时期失效率逐渐增加,这是由于疲劳而导致的损耗失效。
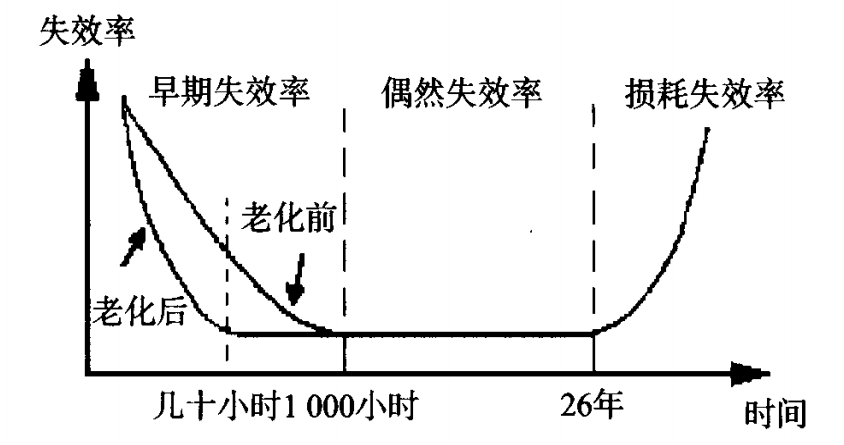
图1同时表明,在常温和器件额定工作条件下进行常规或自然老化,将需要多达1000小时才能使器件度过其早期失效期,很不经济。实践证明,如果在加载额定电气条件的同时提高老化温度(如:125℃),就能使缺陷加速暴露而在较短时间(如:48小时)内产生早期失效,这就是所谓的高温老化。集成电路的高温老化测试对集成电路的可靠性起着极为关键的作用。
老化试验的目的主要是剔除有缺陷的、可能发生早期失效的产品,是一种无损的筛选试验技术。老化筛选可以保证电子元器件的质量,将经过老化筛选的器件用到电子设备上,无疑能减少故障,提高整机的质量。
老化试验又分为静态老化和动态老化,静态老化是指被测器件虽然被加上了电源偏置,但是其内部晶体管没有动作起来。只有被测器件内部晶体管动作起来的老化,才被称为动态老化,是现在最通用的老化试验技术。这种老化又分为动态激励老化和功能性老化。动态激励老化由不同频率的时钟信号对被测器件进行动态激励,功能性老化则是模拟实际使用状态对被测器件施加信号。功能性老化试验能使被测器件更多的内部节点动作起来,被认为是探测有缺陷器件的一种更好的方法。
功能性老化是动态老化的一种,其典型的表现形式为老化中测试TDBI(Test-During-Burn-In),是指将老化与电性能测试有机地结合在一起的方法。TDBI要求在整个老化实验过程中可以检测老化板上每一个器件所有管脚的输入激励信号和输出信号。对被测器件进行功能性老化,对老化所使用的仪器设备要求特别高,既有测试设备的功能又有老化设备的功能,费用非常昂贵。但是由于该技术本身所具有的优势,还是被业界许多厂家所采纳。特别是针对当前复杂的VLSI,TDBI能够提供多种复杂信号及向量集,确保老化效果。能优化老化时间,当失效率达到稳定水平后,就终止老化,由于每批器件的老化时间可能相距甚远,可以节省可观的成本。可精确地检测故障至单元级,由此可进行失效机理分析以改进制造工艺。可检测到“可恢复性”故障,某些器件在老化过程中失效,但在冷却时又复原并能通过后续的电测试,只有TDBI能检测这类器件缺陷。
大规模集成电路的一般老化办法
集成电路老化测试是在封装后进行的加速寿命测试,主要包括在高温高压条件下进行的电压测试,电流测试,时序特性测试和功能测试等。大规模集成电路老化技术与传统的电子元器件老化技术从根本上来说,其原理和作用相同,但由于大规模集成电路的功能非常复杂,采用什么样的向量对其进行老化是非常棘手的,但又是十分关键的。一般情况下,忽略被测器件的具体结构,仅从功能上考虑老化向量集,以确定被测器件是否能正确地执行其功能。如下将以FPGA和DSP两类常见的大规模数字芯片为例来说明其一般老化方法。
对于FPGA和DSP这类VLSI系统级芯片,通常根据芯片应用情况,组合成最小应用系统进行功能性老化。其主要老化过程是在高温高压条件下进行扫描链测试(Scan Test)和内建自测试(Built-in Self Test),即通过外部激励向量或芯片内部自运行老化测试程序模块化、层次化地验证组合及时序逻辑以及各功能模块。激励向量和测试程序尽可能模拟实际工作状态,使电路内部的逻辑单元都有机会得到翻转,实现高覆盖率。老化机台及被老化芯片通常遵循如下的老化流程(图2)。

图2 大规模集成电路老化流程
首先,老化机台配置老化芯片所需的各规格供电电源(DPS),并通过其I/O口控制老化芯片加载老化测试程序,FPGA需外挂Flash加载程序而DSP老化前需预烧录老化测试程序。程序加载完成后,老化机台启动被老化芯片的老化测试过程。
其次,老化芯片自行完成功能性老化测试。通常老化测试涉及多个模块和功能的验证,其结果按测试项目顺序存入芯片自定义的内部寄存器(变量)中。按照芯片功能结构特点,FPGA和DSP可采用的功能测试验证项目如下表所示(表1)。表中老化测试项目可依据老化目的、芯片应用场景和老化成本做相应增减。
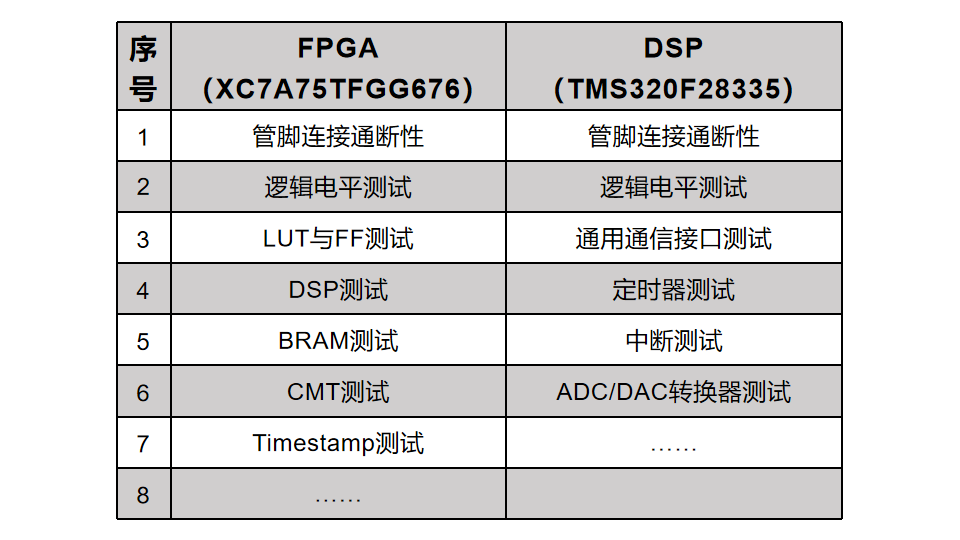
表1 FPGA/DSP功能老化测试项
最后,老化机台通过通信接口(如:SPI)获取被老化芯片老化测试结果并控制结束单次老化流程。实际的老化试验(筛选)过程则是上述单次老化流程的循环执行并包括详细的数据记录和结果报告。
新一代国产老化测试机台LSIC2000
集成电路的高温动态老化在国外主要集中在集成电路制造厂及专业老化测试服务公司,其老化测试台专用性强、容量大但通用性差。在我国,集成电路的老化筛选主要集中在国家重点研究所和整机厂进行二次老化筛选,要求相应的老化设备具有小批量、多品种的特性,即能够同时对多种不同类型、不同规模的集成电路进行老化筛选。
针对上述的特殊需求,国内的可靠性设备厂已自主开发了三代集成电路高温动态老化系统,如90年代中期开发的第3代老化台ELEA/BTI200系列等。随着集成电路产品的飞速发展,多管脚封装芯片、大规模微处理器及大容量存储器的应用日益广泛,国内现有的集成电路老化系统已不能满足需求。另外,国军标(GJB)的贯彻实施也对集成电路的高温动态老化提出了新的要求和规范。
针对前述高温动态老化(Dynamic Burn-in)及老化中测试(TDBI)的需求,九博体育官方app下载成功研发出新一代大规模集成电路老化测试机台LSIC2000(图3)。该机台全面兼容和对标国际领先机型,并具有明显的性价比优势,成为国内半导体先进设备国产替代的最佳选择。

图3 LSIC2000大规模老化测试机台

图4 LSIC2000上位机操作界面示例
结束语
高温老化试验仍然是目前最行之有效的保证集成电路芯片质量和可靠性的筛选方法。静态老化对于大规模集成电路而言有明显的缺陷和不足,因此动态老化及老化中测试是解决这一问题的关键方法。
针对FPGA和DSP两类最常见的大规模集成电路芯片,本文对其一般老化方法、流程进行了详尽说明。但由于VLSI系统级芯片种类繁多结构复杂,制定出相应的规范标准及老化方法和结果评价体系仍然是集成电路可靠性保障工作的重要课题之一。
新一代国产老化测试机台LSIC2000以大规模集成电路为老化对象,能满足高温动态老化及老化中测试的高端需求,全面兼容和对标国际领先机型,为半导体先进设备国产替代提供了最佳选择。
